(走査)透過電子顕微鏡 ((S)TEM)
(Scanning) Transmission Electron Microscope ((S)TEM)
触媒の貴金属粒子径や分散状態など、触媒の性能要因や劣化要因となる構造情報を明らかにし、材料設計指針を提示する。
用 途
触媒粉末やMEA断面の微細構造観察
原 理
・TEMモードでは、光学顕微鏡と同様に平行な電子線をサンプルに照射し、透過した電子線を検出。電子回折により結晶構造解析も可能。
・STEMモードでは、SEMと同様に細く絞った電子線を走査し、透過した電子線やサンプル内で散乱された電子線、サンプル表面から発生した二次電子を検出。 EDS(Energy Dispersive X-ray Spectroscopy)検出器と組み合わせることで、元素分析も行える。
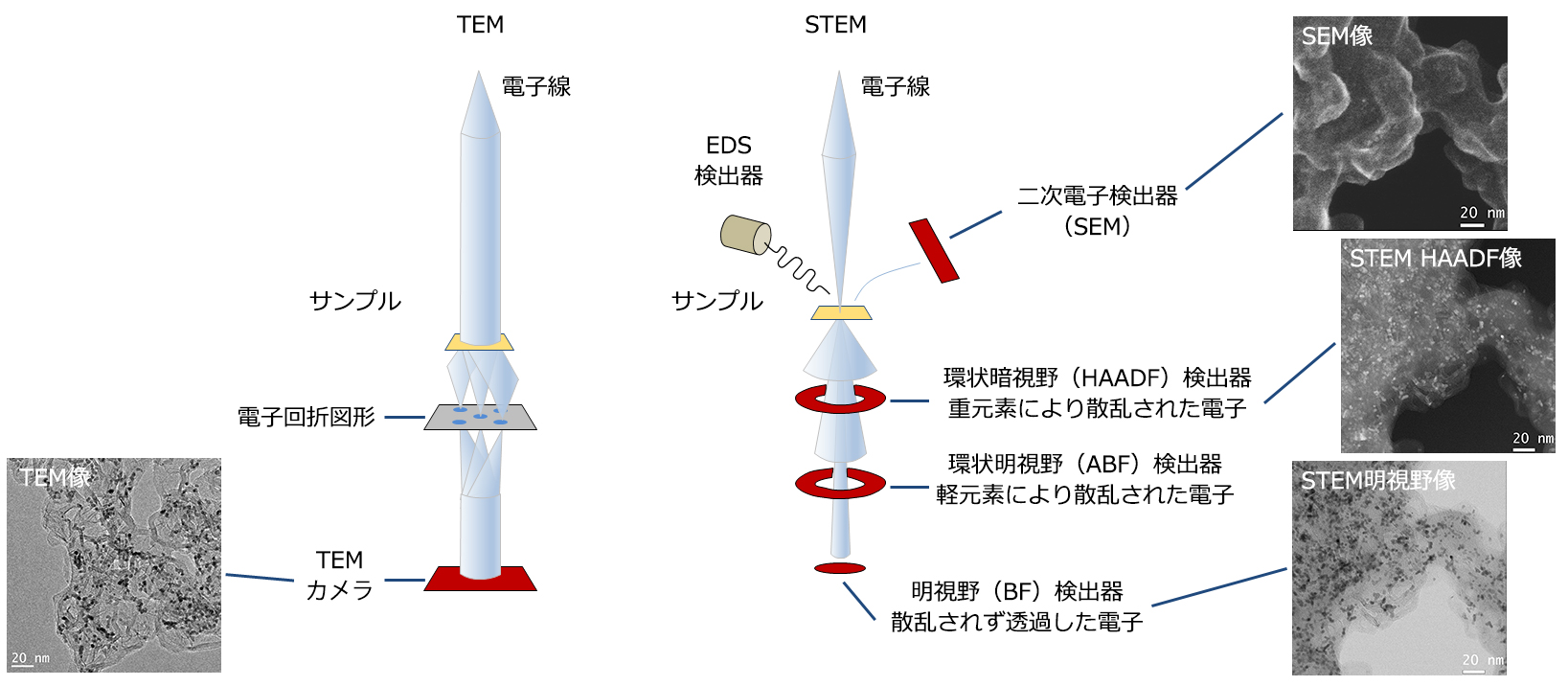
装 置

JEM-ARM300F
(日本電子製)
特 長
・ナノスケールの形態観察、構造解析、元素分析が可能。
・特殊な試料ホルダーを用いることで、3D観察や凍結試料の観察、液中観察も可能。
仕 様
電子銃: 冷陰極電界放出型電子銃(Cold FE)
加速電圧: 80, 120, 200, 300 kV
分解能: TEM, STEM 0.2nm
検出器: TEM カメラ (形態、微細構造、結晶構造情報)
STEM 明視野検出器 (形態、微細構造情報)
STEM 環状暗視野検出器 (組成、微細構造情報)
二次電子検出器 (表面形態情報)
EDS検出器 (元素情報)
付属設備: 高傾斜ホルダー (±80°)
冷却ホルダー(Gatan Model915:室温~-170℃)
液中観察ホルダー(Protochips社製Poseidon)
